





RECOMMENDED
2022年4月14日,由大华重工自主研发的CMC系列履带移动颚式破碎站成功交付。卓越的品质和完善
在刚刚过去的一年中,铁路、房地产等行业投资规模大幅萎缩,这直接引发了破碎机械行业的产品需求明显减
与封装之间是不可分割的整体,没有一个芯片能不用封装就能正常工作,封装对芯片来说是必不可少的。
随着IC生产技术的进步,封装技术也在不断更新换代,每一代IC都与新一代的IC封装技术紧密相连。在业界,先进封装技术与传统封装技术以是否焊线来区分。
先进封装技术在提升芯片性能方面展现的巨大优势,吸引了全球各大主流IC封测厂商在先进封装领域的持续投资布局。
从中国半导体封装产业的发展来看,全球封装技术经历了五个发展阶段。目前,行业的主流在第三阶段主要是CSP和BGA封装,在第四和第五阶段正向sip、SOC、TSV等封装迈进。
近年来,国内领先的封装企业通过自主研发、并购,在第三、四、五阶段逐步掌握了一些先进的封装技术,但国内市场主流封装产品仍处于第二、三阶段。
虽然近年中国本土先进封测四强(长电、通富、华天、晶方)通过自主研发和兼并收购,已基本形成先进封装的产业化能力,但从先进封装营收占总营收的比例看,中国先进封装技术水平与国际领先水平还有一定的差距。
据统计,2018年中国先进封装营收约为258.9亿元,占中国IC封测总营收的11.8%,远低于全球41%的比例。
2018年中国封测四强的先进封装产值约占中国先进封装总产值的21%,其余内资企业和在大陆设有先进封装产线的外资企业、台资企业的先进封装营收约占79%。

根据市场调查与研究机构 Yole 统计数据,全球集成电路封测市场长期保持平稳增长,从2011年的455亿美元增至2020年的594亿美元,年均复合增长率为3.01%。

根据中国半导体行业协会统计数据,2009年至2020年,我国封测行业年均复合增长率为15.83%。2020年我国封测行业销售额同比增长6.80%。国内市场所需的高端集成电路产品,如通用处理器、存储器等关键核心产品仍然依赖进口。因此,中国的封装产业本土化发展的潜在能力巨大。

同集成电路设计和制造相比,我国集成电路封测行业已在国际市场具备了较强的竞争力。
2020年全球前10名封测有突出贡献的公司中,中国大陆地区已有3家企业上榜,并能够和日月光、安靠科技等国际封测企业同台竞争。
随着我国集成电路国产化进程的加深、下游应用领域的蓬勃发展以及国内封测有突出贡献的公司工艺技术的慢慢的提升,国内封测行业市场空间将进一步扩大。
预计到2027年IC封装市场规模达到3602亿元,先进封装市场规模将达到667.4亿元,先进封装将占到市场规模的18%以上。

根据中国半导体行业协会封装分会发布的《中国半导体封装测试产业调研报告(2020年版)》,2019 年国内集成电路封测企业出售的收益前 28 家企业情况如下:

从生产和销售规模上看,国内的集成电路封装测试企业多数为外资半导体公司在华建立的独资或控股的封测企业,总体上内资企业在行业中尚处于相对弱小的地位。
国际半导体公司在华设立的制造厂,其产品全部返销回母公司,因而与国内市场基本脱节,不会与内资封测企业构成直接竞争关系。国内市场的竞争大多分布在在内资和内资控股企业之间。
集成电路封装和测试行业属于资本和技术密集型行业,资金门槛和技术门槛较高,因此国内大量小规模中低端封测企业在行业不构成竞争威胁。
随着台积电宣布 2nm 制程工艺实现突破,集成电路制程工艺已接近物理尺寸的极限,集成电路行业进入了“后摩尔时代”。
“后摩尔时代”制程技术突破难度较大,工艺制程受成本大幅度增长和技术壁垒等因素制约,上升改进速度放缓。
由于集成电路制程工艺短期内难以突破,通过先进封装技术提升芯片整体性能成为了集成电路行业技术发展趋势。
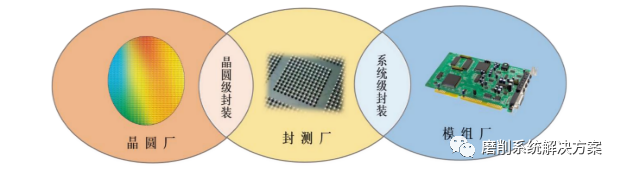
为了在更小的封装面积下容纳更多的引脚,先进封装向晶圆制程领域发展,直接在晶圆上实施封装工艺,通过晶圆重构技术在晶圆上完成重布线并通过晶圆凸点工艺形成与外部互联的金属凸点。
晶圆级封装代表性技术有:晶圆上制作凸点工艺(Bumping)、晶圆重构工艺、硅通孔技术(TSV)、晶圆扇出技术(Fan-out)、晶圆扇入技术(Fan-in)等。
将以前分散贴装在PCB板上的多种功能芯片,包括处理器、存储器等功能芯片以及电容电阻元器件集成为一颗芯片,压缩模块体积,缩短电气连接距离,提升芯片系统整体功能性和灵活性。
代表性技术有:系统级封装技术(Sip),包括采用了倒装技术(Flip-Clip)的系统级封装产品。
长期以来,半导体产业角逐的主战场是在芯片设计以及芯片制造环节,但在后摩尔时代,伴随着5GAI物联网,大数据等技术不断突破创新,业内对于体积更轻薄,数据传输速率更快,功率损耗更小及成本更低的芯片需求大幅度提高,这使得单纯依靠精进制程来提升芯片性能的方法已不足以满足时代需求。
而先进封装技术可缩短尺寸,减轻重量,其节约的功率可使相关元件以每秒更快的转换速度运转而不增加能耗,同时更有效地利用硅片的有效区域,而且先进封装设计自由度更高,开发时间更短。
所以先进封装被视为推动产业高质量发展的重要杠杆,也一度被称作是超越摩尔定律瓶颈的最大杀手锏。
面对重要的发展机遇,封装厂,IDM厂商,晶圆厂,基板/PCB供应商,以及EMS/ODM等众多厂商都在竞相布局先进封装研发和产能,而这必将冲击传统封装市场的旧有格局和发展模式。
技术,它旨在通过创新的技术方法,将多个芯片或其他电子元器件以更高的集成度、更小的尺寸、更低的功耗和更高的可靠性集成在一起。这种技术不仅提升了电子科技类产品的性能,还满
的电、热、光和机械性能,决定着电子科技类产品的大小、重量、应用方便性、寿命、性能和成本。针对集成电路领域
技术综述 /
电压是指在地面表面,由于电流流经大地时产生的电位差。当一个人站在这样的地面上,他的两只脚之间会存在一定的电位差,因此导致电流通过人体,可能引发触电事故。
技术 /
是一种超越摩尔定律的重要技术,它能够给大家提供更好的兼容性和更高的连接密度,使得系统集成度的提高不再局限于同一颗芯片。
三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代
的区别 /
电压是一种在电力系统中产生的瞬时电压突变现象。它通常在电力设备突然连接或断开电网时发生,例如高压开关或断路器的操作。
电压可能对电网和连接的设备产生不良的影响,因此对于电力系统的稳定性和可靠性
技术可以将多个半导体芯片和组件集成到高性能的系统中。随着摩尔定律的缩小趋势面临极限,
为持续改善计算性能、节能和功能提供了一条途径。但是,与亚洲相比,美国目前在
实现不同技术和组件的异构集成 /
。其中HRP(Heat Re-distribution Packaging)晶圆级
芯片) /
基本术语 /
方式,从技术实现方法出现了倒装(FlipChip),凸块(Bumping),晶圆级
技术包括哪些技术 /
技术在下游应用需求驱动下加快速度进行发展。特别是超算、物联网、智能终端产品等对芯片体积和功耗
“芯”火花! /
三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代
有什么区别? /
三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代
工艺流程 /
基于ADP3309_Typical Application直流到直流单输出电源的参考设计
各位大神,求电路图,用MC34063设计出一个升降压DC-DC,输出900mA左右